近日,中京电子投资企业广东盈骅新材料科技有限公司(以下简称“盈骅新材”)已完成相关股权工商变更。通过产业投资,中京电子旨在加强半导体先进封装IC载板材料领域与上游核心材料厂商开展半导体封装应用技术与业务开发合作。
中京电子积极关注产业链协同发展,并努力促进半导体核心材料的进口替代进程,增强供应链快速响应机制和保障机制,该项投资合作有利于促进公司IC封装载板业务的长期发展。

盈骅新材主要从事半导体封装载板基材的产品研发、制造与技术服务。盈骅新材长期致力于先进封装领域高性能树脂材料、先进封装载板用BT基材以及FC-BGA封装载板用ABF增层膜的研发以及产业化,其技术研发与创新能力达到国际先进水平,是国内较早开发半导体封装载板用BT基材和芯板的企业。盈骅新材的BT基材已在MiniLED显示、存储芯片、传感器芯片等领域实现批量供货,其ABF载板增层膜已经向全球ABF载板龙头企业送样,应用于CPU、GPU、AI等芯片领域。
半导体封装基板(IC载板)系中京电子重点发展的战略产品,封装基板材料(BT/ABF)是IC载板等半导体先进封装材料的核心基础材料,目前主要由日本三菱瓦斯、味之素等国外厂商垄断。盈骅新材为目前国内封装载板基材的先进企业,已实现BT材料等半导体封装基材的批量供货。中京电子与上游核心材料厂商开展深度合作,将与公司IC载板业务形成良好的技术与客户协同,符合公司的战略发展方向。
IC封装载板简述
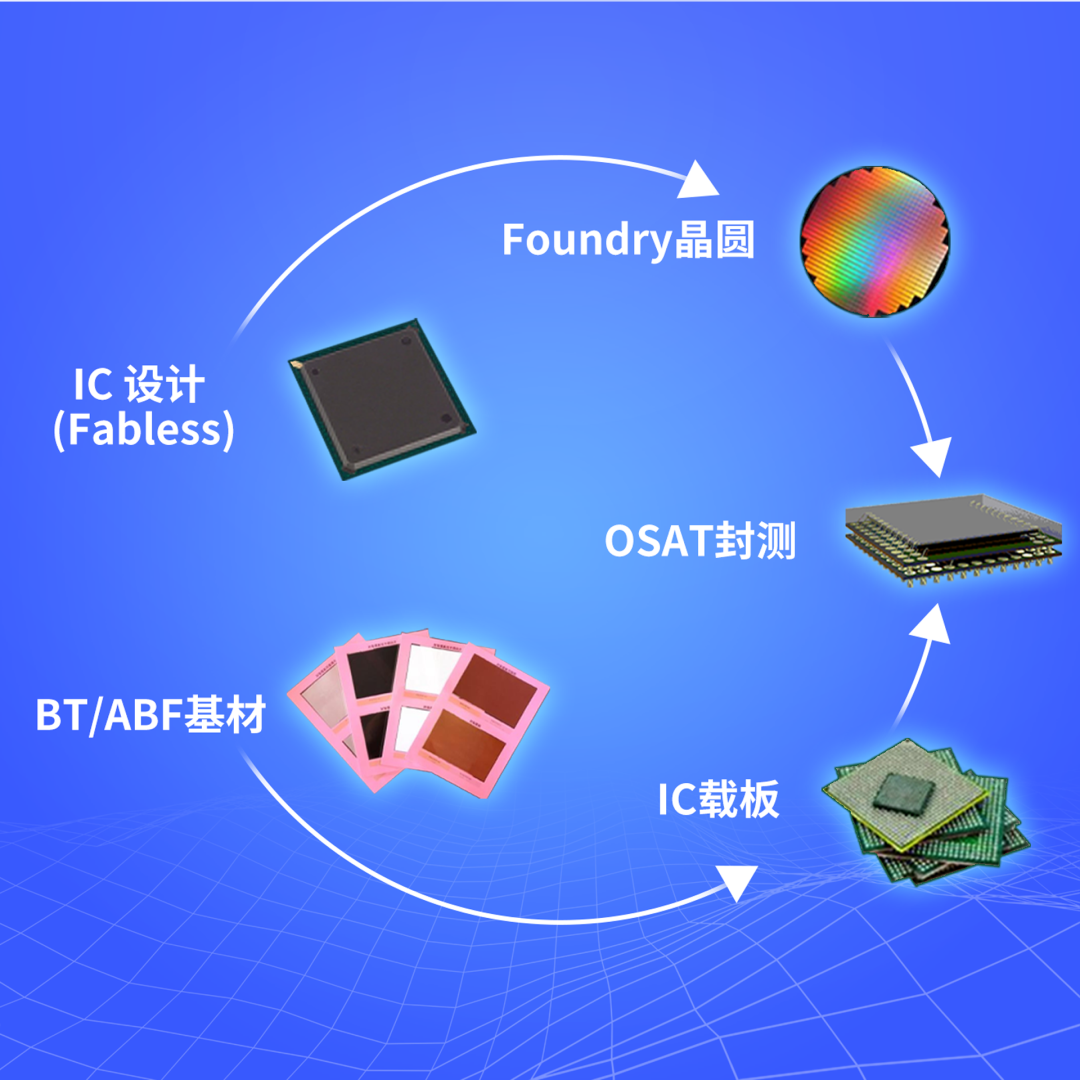
IC载板是介于IC晶圆与PCB之间用于IC封装的核心材料,IC载板内部有电路连接芯片与印制电路板(PCB)之间的信号,主要为保护电路、芯片与PCB间电路连接与导散余热、保护芯片及完成芯片板级封装,为封装制程中的关键零部件,占封装制程35%-55%成本,随着数字化与人工智能的发展、高算力及大容量存储需求提升,5G传输速率及讯号干扰等效能需求提高,IC载板未来需求有望获得快速增长。

BT材料简述
BT材料主要以B(Bismaleimide)和T (Triazine)聚合而成,上世纪90年代Motorola提出BGA构装方式、掌握了关键结构的专利,同时期日本三菱瓦斯化学公司(Mitsubishi Gas Chemical Company,MGC)经拜耳化学公司技术指导所开发出来,在IC封装基板领域、BT树脂拥有专利并商业化量产,发展至今已有30多年历史,推动了电路基板轻薄化、多层化、多功能化的发展。
全球IC载板供不应求,BT载板需求强劲,目前BT材料市场份额中,主要供应商有:日系三菱瓦斯MGC、Hitachi、松下、住友等,韩国有Doosan、LG,台湾地区有南亚、联致等,国内有盈骅新材、生益科技等。盈骅新材是国内首家独立自主开发的封装基材厂商之一,经过多年的市场推广与客户验证,得到苹果、华为、三星等多家终端客户使用认可。
盈骅新材已经成长为封装载板用特殊板材市场主流供应商之一,各系列产品有对标国外同类型类BT板材规格型号,可提30um-1.0mm不同厚度、不同叠构、不同物性指标产品规格型号,做到行业产品需求全覆盖、提供一站式整体解决方案服务,可逐步实现完全国产化替代。
ABF材料简述
ABF全称是“Ajinomoto Build-up Film”,是一种在所有现代集成电路中充当绝缘体的树脂基板。ABF是一种高度耐用和刚性的薄膜,能抵抗温度变化时的膨胀和收缩,使其成为处理器或IC的纳米级和毫米级部件之间的基板。AFB基板由多层微电路组成,被称为“积木基板”,它允许形成这些微型元件,其表面可以接受激光加工和直接镀铜。大多数现代芯片制造商使用ABF来设计其CPU和GPU中较小的组件。ABF载板主要用于CPU、GPU、FPGA、ASIC等高性能运算IC。近年来在5G、AIoT、HPC等应用及Chiplet技术封装趋势带动下,半导体产业链对ABF载板需求大幅提升,开始呈现供不应求态势,价格也持续上扬。加上数字经济、互联网工作等场景推动CPU、GPU等LSI芯片用量倍增,FC-BGA基板需求大增,ABF载板景气上涨。
其中, Chiplet 技术的发展将会增大芯片封装面积,提升 ABF 载板用量,以Chiplet技术为代表的异质异构集成的核心在于通过先进的封装技术,将不同工艺、不同材质的 Chiplets封装在同一个芯片中,以实现芯片性能、良率的提升和成本的降低;这会导致其集成芯片的尺寸将会更大,预计Chiplet技术在提升芯片性能的同时,也将大大增加了对载板材料的消耗。
盈骅新材生产的ABF载板增层膜已经向全球ABF载板龙头企业开始送样验证。
盈骅新材Low CTE材料简介
材料:Y-201TS、Y-201TSR
特性:low CTE,白料,高白度高反射率,高Tg200,尺寸稳定性和厚度均匀性好,高耐热性能。
应用:Mini/Micro-LED背光显示基板,Chip on Board(COB)封装。
材料:Y-206BSM、Y-206BSR
特性:low CTE,黑料,高Tg210,高模量高刚性,光遮蔽性能高,尺寸稳定性和厚度均匀性好,高耐热性能,高信赖性能。
应用:Mini/Micro-LED直接显示基板,打金属线类memory封装基板,CSP BGA金线类封装基板。
材料:Y-207HS
特性:low CTE,黑料(或棕色),高Tg240,高模量高刚性,优异的尺寸稳定性和厚度均匀性,低翘曲性能,高耐热性能,高信赖性和可靠性。
应用:打金属线类memory封装基板,CSP BGA金线类封装基板,射频模组类基板,FC-CSP、FC-BGA倒装芯片用封装基板。
材料:Y-208HS
特性:low CTE,黑料(或棕色),高Tg240,高模量高刚性,优异的尺寸稳定性和厚度均匀性,低翘曲性能,高耐热性能,高信赖性和可靠性。
应用:打金属线类memory封装基板,CSP BGA金线类封装基板,射频模组类基板,FC-CSP、FC-BGA倒装芯片用封装基板。
材料:Y-208HS
特性:Very low CTE,黑料(或棕色),高Tg260~280,超高模量和高刚性,优异的尺寸稳定性和厚度均匀性,低翘曲性能,高耐热性能,高信赖性和可靠性。
应用:FC-CSP、FC-BGA倒装芯片用封装基板,射频模组类基板,系统级封装SIP用基板,特别是FC-BGA基板中的ABF的承载板。
材料:Y-209HS
特性:Ultra low CTE,黑料(或棕色),高Tg300~320,超高模量和超高刚性,优异的尺寸稳定性和厚度均匀性,超低翘曲性能,高耐热性能,高信赖性和可靠性。
应用:FC-CSP、FC-BGA倒装芯片用封装基板,系统级封装SIP用基板,特别是FC-BGA基板中的ABF的承载板,适用于2D、2.5D、3D类特高端芯片封装基板。